finfet工艺原理 finfet工艺流程图
 2022-02-17 15:16:46
2022-02-17 15:16:46  22
22FinFET的全称是Fin Field-Effect Transistor。它是一种新型互补金属氧化物半导体晶体管。FinFET 的名称是基于晶体管和鳍片形状的相似性。
FinFET是源自传统标准场效应晶体管 (FET) 的创新设计。在传统的晶体管结构中,控制电流流动的栅极只能控制栅极一侧电路的通断,属于平面架构。在 FinFET 架构中,栅极是类似于鱼鳍的叉形 3D 结构,电路的通断可以在电路的两侧进行控制。这种设计可以大大改善电路控制和减少泄漏,还可以大大缩短晶体管的栅极长度。
一、FinFET工作原理
FinFET全称为场效应晶体管,是一种新型互补金属氧化物半导体晶体管。这项技术的发明者是加州大学伯克利分校的胡正明教授。
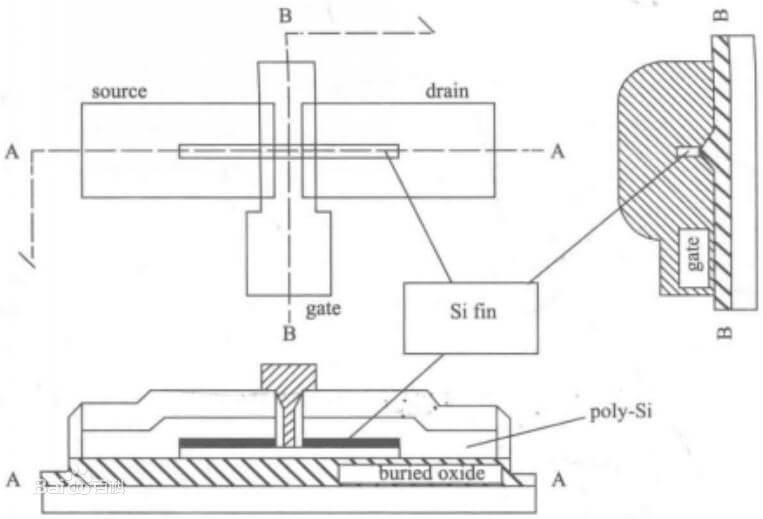
FinFET工作原理图
如图所示,FinFet 与平面 MOSFET 结构的主要区别在于它的沟道是由在绝缘基板上凸起的又高又薄的鳍片组成的。源极和漏极在两端,三个栅极靠近它们的侧壁和顶部,用于辅助电流控制。这种鳍状结构增加了栅围绕沟道的面积,加强了栅对沟道的控制,可以有效缓解平面器件中的短沟道效应。它极大地改善了电路控制和减少漏电流,还可以大大缩短晶体管的栅极长度。由于这一特性,Finfet不需要在沟道中进行高掺杂,因此可以有效降低杂质离子散射效应,提高沟道载流子迁移率。
二、FinFET 结构
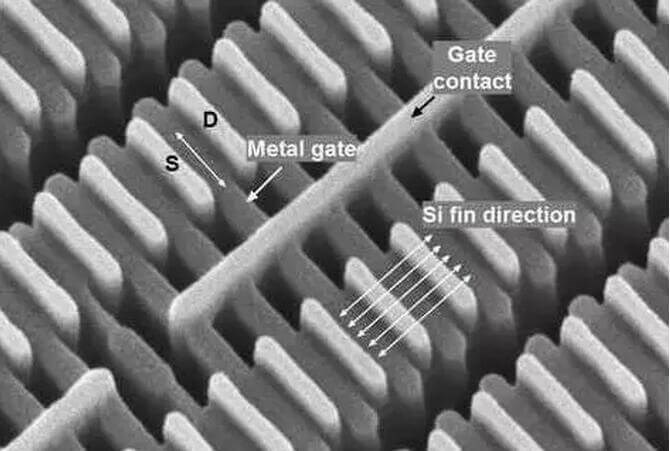
FinFET的电子显微镜照片
如图所示,FinFET的主要特点是沟道区是由栅极包围的鳍状半导体。鳍片的长度与源极和漏极方向的长度就是沟道长度。栅极缠绕结构增强了栅极的控制能力,提供了更好的沟道电控制,从而降低了漏电流,抑制了短沟道效应。但是,FinFET的种类很多,不同的FinFET具有不同的电特性。下面将根据衬底类型、沟道方向、栅极数量、栅极结构分别进行介绍。根据 FinFET 基板,FinFET 可分为两种。一种是 SOI FinFET,另一种是体 FinFET。体FinFET形成在体硅衬底上。由于制造工艺的不同,体硅衬底与SOI衬底相比具有缺陷密度低、成本低等优点。此外,由于SOI衬底中埋氧层的导热系数较低,体硅衬底的散热性能也优于SOI衬底。
Bulk FinFET 和 SOI FinFET 具有相似的寄生电阻和寄生电容,可以在电路级别提供相似的功率性能。然而,SOI衬底的轻鳍掺杂FinFET表现出比体FinFET更低的结电容、更高的迁移率和电压增益的电性能。
这种结构的特点如下:
1)超薄Si fin抑制短沟道效应;
2)两个栅极是自对准的,并且与源漏也对准;
3)在源漏区生长多晶硅可以降低寄生电阻;
4)短(50nm)Si fin为准平面结构;
5)后栅极制造工艺与低温和高K栅极电介质兼容。
三、FinFET应用
应变锗量子阱沟道P型金属氧化物半导体(MoS)鳍式场效应晶体管的实际应用表明鳍式场效应晶体管和三栅结构具有应用于7mm和5nm CMOS器件的可能性。
自CMOS器件发展到90m工艺以来,将硅锗源漏极嵌入器件中一直是生产应变硅增强P型MOS器件的常用方法。器件尺寸的减小使得源极和漏极中的应变空间极为有限。具有薄结构的鳍型场效应晶体管难以进一步小型化。将高应变材料直接应用于沟道将是 CMOS 器件继续小型化的可行途径。
比利时微电子研究中心在松弛的硅锗缓冲层上生长了一个高度应变的锗通道。该方法已证明该方法可以提高沟道电子迁移率,并具有缩小沟道尺寸的良好潜力。使用鳍片替换技术制造应变锗沟道器件对于在传统硅衬底上实现与其他器件的集成非常有用。建立在硅锗沟道缓冲层上的应变锗P沟道鳍式场效应晶体管的跨导峰值在0.5V源漏电压下为1.3ms/μm,具有良好的短沟道控制,低至60mm栅极长度能力。该器件的亚阈值斜率跨导高于已宣布的弛豫锗鳍场效应晶体管。
四、FinFET 优势
FinFET 器件相对于传统的平面晶体管具有明显的优势。首先,FinFeT沟道一般为轻掺杂甚至不掺杂,避免了离散掺杂原子的散射效应。与重掺杂平面器件相比,载流子迁移率将大大提高。此外,与传统平面 CMOS 相比,FinFET 器件在抑制亚阈值电流和栅极漏电流方面具有绝对优势。FinFET双栅或半环栅的体鳍结构增加了沟道的栅控面积,大大增强了栅控能力,有效抑制了短沟道效应,降低了亚阈值漏电流。由于短沟道效应的抑制和栅极控制能力的增强,finFET器件可以使用比传统更厚的栅氧化层,这样FinFET器件的栅漏电流也会降低。显然,FinFET 优于 PDSOI。而且,由于 FinFET 在工艺上与 CMOS 技术相似,因此在技术上更容易实现。因此,它已被许多大公司用于制造小尺寸IC。
五、技术发展现状
2011年初,英特尔推出了商用FinFET,用于其22nm节点工艺。台积电等主要半导体代工厂也开始计划推出自己的 FinFET。从2012年开始,FinFeT开始向20mm节点和14nm节点推进。
未来发展重点:在锗硅中实现P型掺杂,以提高器件性能,优化锗上硅钝化层的厚度,提高沟槽栅的绕线效果。本研究验证了具有鳍式场效应晶体管结构的锗锗硅异质量子阱器件不仅可以提供应变能力,还可以增强沟道控制。
鳍片置换技术的使用实现了II-V族材料在CMOS器件结构上的应用。该研究成果使得利用锗通过鳍片置换工艺形成CMOS器件的沟道成为可能。这是实现单片异质集成和开发CMOS器件和片上系统的关键技术。
比利时微电子研究中心的下一代 FinFET 研究是其核心 CMOS 项目的一部分。
未来:GAA-FET(Gate-All-Around)将取代 FinFET
FinFET在22nm节点的首次商业化,为芯片“大脑”中的晶体管-微型开关的制造带来了颠覆性的变化。与以往的平面晶体管相比,三边与栅极接触的“鳍片”形成的沟道更容易控制。然而,随着 3nm 和 5nm 技术节点面临的问题不断积累,FinFET 的有效性已经达到了极限。
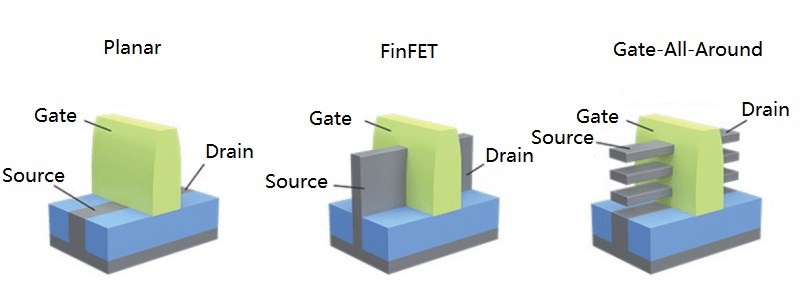
平面 FET、FinFET 和 GAA-FET
1)晶体管缩放的困境
在每个技术节点,设备制造商都可以通过缩小晶体管来减少器件面积、成本和功耗,并实现性能提升。这种方法也称为 PPAC(功率、性能、面积、成本)缩放。然而,FinFET 尺寸的进一步减小将限制驱动电流和静电控制能力。
在平面晶体管中,可以增加沟道宽度以驱动更多电流并提高开启和关闭速度。但随着CMOS设计的发展,标准单元的轨道高度不断降低,导致“鳍”尺寸受到限制,基于5nm以下节点制造的单鳍器件将无法提供足够的驱动电流。
此外,虽然“鳍”的三个侧面都受闸门控制,但仍有一侧不受控制。随着栅极长度的缩短,短沟道效应会更加明显,更多的电流会通过器件底部的非接触部分泄漏。因此,尺寸较小的设备将无法满足功耗和性能要求。
2)用纳米薄片代替鳍片
Gate-All-Around ( GAA ) 是一种改进的晶体管结构,其中沟道的所有侧面都与栅极接触,因此可以实现连续缩放。具有这种结构的晶体管称为全环栅极 (GAA) 晶体管,并且已经出现了这种晶体管的许多变体。
早期的 GAA 器件采用垂直堆叠纳米薄片的方法,即将水平放置的薄片彼此分开放置在栅极中。与 FinFET 相比,这种方法下的通道更容易控制。并且与 FinFET 必须排列多个鳍片以增加电流不同,GAA 晶体管只需垂直堆叠几片纳米片,并让栅极包裹沟道即可获得更强的载流能力。这样,只需要对这些纳米薄片进行缩放,就可以对晶体管尺寸进行调整以满足特定的性能要求。
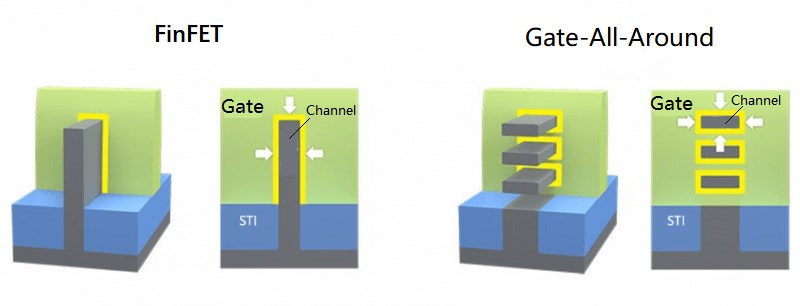
FinFET 和 GAA FET
然而,与鳍片一样,随着技术的进步和特征尺寸的不断减小,鳍片的宽度和间距将继续缩小。当薄片的宽度几乎等于厚度时,这些纳米薄片看起来更像“纳米线”。
3) 制造挑战
虽然纳米片的概念很简单,但它给实际制造带来了许多新的挑战。一些制造问题源于结构,而另一些则与满足 PPAC 规模目标所需的新材料有关。
具体来说,建筑的主要挑战源于结构的复杂性。制作GAA晶体管,首先需要交替使用Si和SiGe外延层形成超晶格并以此作为纳米片结构的基础,然后在内部下沉介电隔离层,去除牺牲层通过蚀刻的通道。去除牺牲层后留下的空间,包括纳米片之间的空间,需要用由电介质和金属制成的栅极填充。未来的门极有可能使用新的金属材料,其中钴已进入评估阶段;制造商也考虑了钌、钼、镍和各种合金。
4) 持续进步
GAA晶体管最终将取代FinFET,其中的纳米片将逐渐发展为纳米线。GAA 结构应该能够适用于计划中当前包含的所有高级流程节点。
从最早的平面结构开始,晶体管架构取得了长足的进步,有力地推动了智能互联的发展,这一切都是早期行业先驱者无法想象的。随着全封闭栅极晶体管的问世,我们也热切期待它为世界带来更多令人惊叹的终端用户设备和功能。








